晶圆是用来制造IC芯片的基础材料,由晶体和硅熔体通过熔晶工艺制造出晶圆棒,再通过切片方式制造出单片晶圆,晶圆划片则是划线出单个晶体单位。
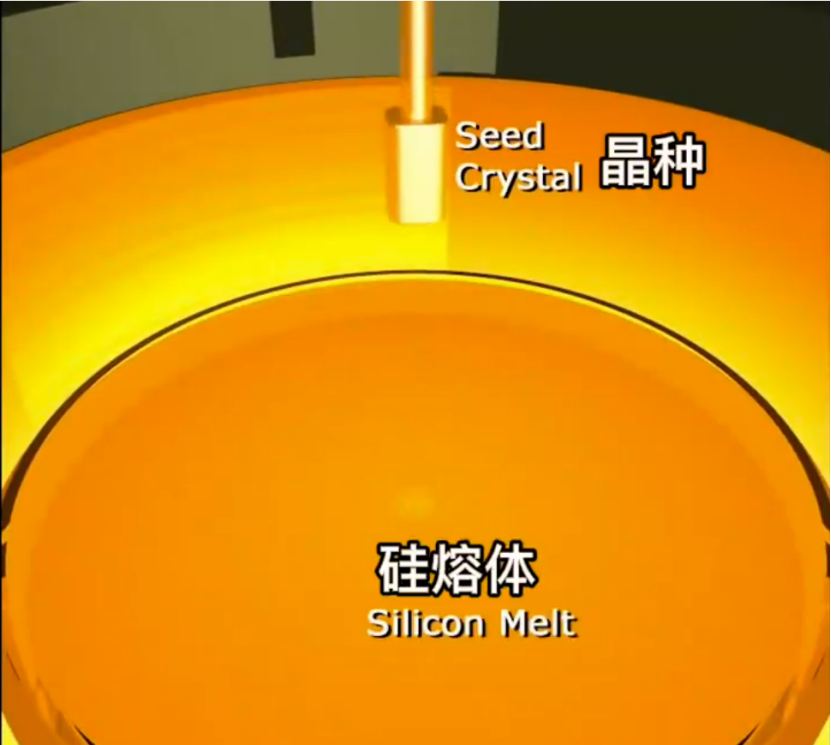

晶圆划片工艺已经不再只是把一个硅晶圆划片成单独的芯片这样简单的操作。随着更多的封装工艺在晶圆级完成,并且要进行必要的微型化,针对不同任务的要求,在分割工艺中需要对
不同的操作参数进行调整。例如,分割QFN封装需要具有可以切割柔性和脆性材料组成的复合基板的能力。MEMS封装则常常具有微小和精细的结构;梁、桥、铰链、转轴、膜和其他敏感形态;这些都需要特别的操作技术和注意事项。在切割硅晶圆低厚度,或者像GaAs这样的脆性材料时,又增添了额外的挑战例如碎片、断裂和残渣的产生。

划片方法主要有刀具划片、激光划片。
刀具划片:是以强力磨削为手段,通过空气静压支撑的电主轴带动超薄金刚石刀片以高速旋转,用刀片上的微细磨粒与被加工物进行接触,使划切处的材料产生碎裂。

劣势:
刀片划片直接作用于晶圆表面,在晶体内部产生损伤,容易产生晶圆崩边及晶片破损;
刀片具有所的厚度,导致刀具的划片线宽较大;
耗材大,刀片需每半个月更换一次;
环境污染大,切割后的硅粉水难处理。
激光划片:利用高能激光束聚焦产生的高温使照射局部范围内的硅材料瞬间气化,完成硅片分离。
优势:
对芯片的电性影响小,可提高的划片成品率;
可以对不同厚度的晶圆进行作业,具有更好的兼容性和通用性;
可以切割一些较复杂的晶圆芯片,如六边形管芯等;
不需要去离子水,不存在刀具磨损问题,并可连续24小时作业。

